シリコンテクノロジーは「熱酸化」という表面不活性化技術の確立により幕を開けました。1965年、当時フェアチャイルド・セミコンダクター社にいたDealとGroveが、Si熱酸化膜の成長速度を記述するユニバーサルな線形‐放物型方程式を導き1)、以後これがSi熱酸化の標準理論として定着しました。
ちなみにGroveは、この有名な理論を発表した3年後に、NoyceとMooreが設立したインテル社に合流しました。Groveがインテル社の社長を務めたとき、稼ぎ頭のDRAM事業からMPU事業への大転換を決断しました。またCEO時代には、CISC対RISCでMPU戦略が混乱する中、あえてCISC一本化を決断し、MPUメーカとして不動の地位を築きました。Groveはインテル社を今日の巨大企業に育て上げた立役者であり、名経営者として有名です。
Deal-Groveモデルの概要
DealとGroveの熱酸化モデルによると、酸化膜(SiO2膜)の厚さが薄い初期の段階では界面反応が律速となり、SiO2膜厚は時間に対して線形に増加します(線形領域)。一方、SiO2膜厚が厚くなると、SiO2膜中を酸化種が拡散する過程が律速となり、SiO2膜厚は時間の平方根に比例して増加するようになります(放物型領域)。
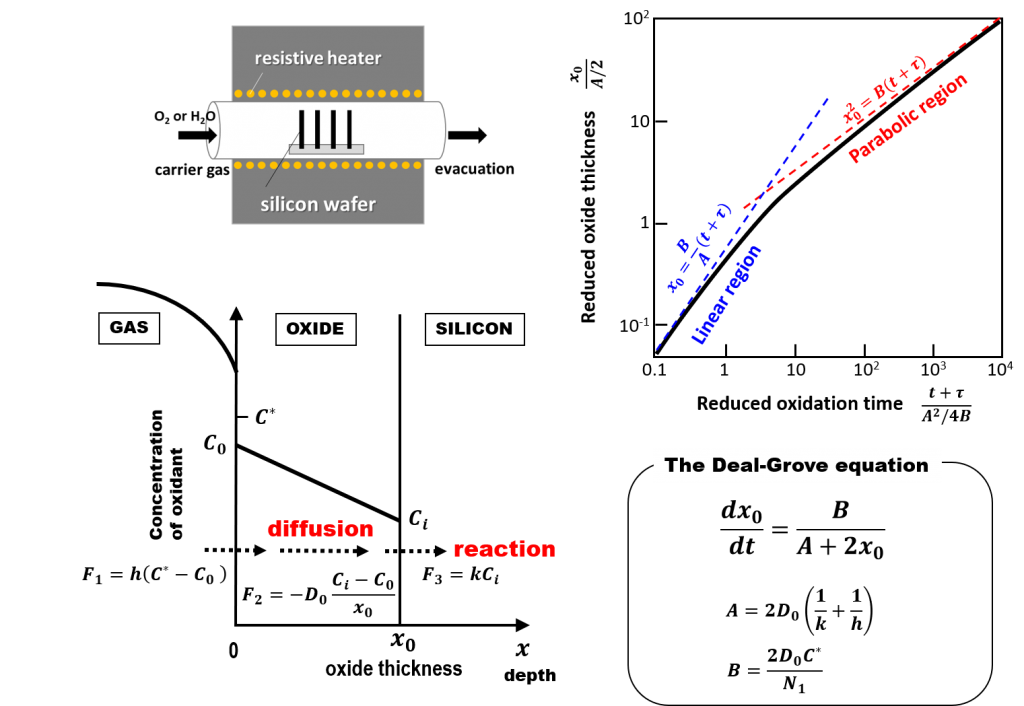
Deal-Groveモデル1)。気相からSiO2膜表面への酸化種の流速F1、SiO2膜中の拡散による流速F2、SiO2/Si界面での反応による消費速度F3が定常状態でつり合うとして導かれたSiO2膜厚x0に関する微分方程式。初期の段階ではx0は時間に比例して増加し(線形領域)、x0が厚くなるとx0の2乗が時間に比例する(放物型領域)。
実験データから抽出した線形領域の比例係数(図中のB/A)の活性化エネルギーは、乾燥酸素雰囲気中の酸化(ドライ酸化)も、水蒸気雰囲気中の酸化(ウェット酸化)も、ともに2.0eV程度でした。これがSi-Si結合のエネルギーに近いことから、酸化種がO2かH2Oかにかかわらず、同様の界面律速過程に支配されているだろうとDealとGroveは推測しました。
一方、放物型領域の速度係数(図中のB)の活性化エネルギーはドライ酸化で1.24eV、ウェット酸化で0.71eVと、かなり異なります。前者は溶融シリカ中のO2分子の拡散障壁に近く、後者はH2O分子の拡散障壁に近いことから、酸化種分子がSiO2膜中を拡散するプロセスが律速となっているとDealとGroveは結論しました。
ドライ酸化の初期異常
ただし、ドライ酸化のごく初期、SiO2膜厚約40nmまでの領域は、Deal-Groveの線形-放物型方程式の予測よりも酸化が著しく速く進みます。これに対してウェット酸化では、酸化膜厚ゼロの初期から線形-放物型方程式に忠実に従います。
DealとGroveはこのドライ酸化にみられるズレの原因についても言及しています。彼らは、酸化膜中ではO2分子がO–2イオンと正孔に解離しており、酸化膜が薄い初期の段階では、高い移動度を有する正孔がO–2イオンを引っ張る効果が顕在化し拡散速度が増加するために、初期の酸化が著しく速く進むと考察しました。
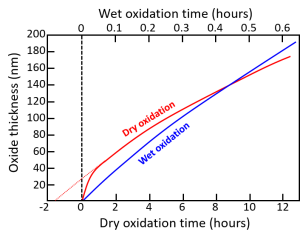
ドライ酸化とウェット酸化における極初期のSiO2膜成長曲線1)。ウェット酸化はSiO2膜厚ゼロからDeal-Grove方程式に従うが、ドライ酸化は膜厚40nm程度まで成長速度がDeal-Grove方程式の解より著しく増大する。
しかし、このDealとGroveの「初期増速拡散」説は、1983年、Fargeixらが行った解析により否定されました2)。ドライ酸化で初期の酸化が著しく速く進む原因は、拡散速度が上がるためではなく、界面における酸化速度が増加していると解釈しなければ、実験事実を説明できないことが判明したのです。
ところが話はこれで終わりではありません。2006年に筆者(渡邉)が発表した新しい線形-放物型方程式3)で、Fargeixらの実験の解釈が180度変わり、DealとGroveの「初期増速拡散」説が復活することがわかりました。
これから数回にわたって、シリコン熱酸化のメカニズムの解釈の変遷の歴史を紹介していきたいと思います。
- B. E. Deal, A. S. Grove, J. Appl. Phys. 36, 3770 (1965).
- A. Fargeix, G. Ghibaudo, G. Kamarinos, J. Appl. Phys. 54, 2878 (1983).
- T. Watanabe, K. Tatsumura, I. Ohdomari, Phys. Rev. Lett., 96, 196102 (2006).